
导电原子力显微镜 (C-AFM)
探测样品表面局部电子结构。
随着半导体行业中器件尺寸和关键尺寸的不断减小,局部测量电学性质并具有高空间分辨率的能力对于准确的器件表征和失效分析至关重要。在这里,原子力显微镜(AFM)提供了纳米尺度上局部表面特性的真实空间成像。特别是导电原子力显微镜(C-AFM),它通过在施加的直流偏压下使用涂有导电材料的探针作为纳米级电探针来扫描表面,从而同时测量样品的形貌和电导率。
探测样品表面的局部电子结构
随着半导体行业中器件尺寸和关键尺寸的不断减小,使用高空间分辨率局部测量电学性质对于准确的器件表征和失效分析至关重要。在这里,原子力显微镜(AFM)提供了纳米尺度上局部表面特性的真实空间成像。特别是导电原子力显微镜(C-AFM),它通过在施加的直流偏压下使用涂有导电材料的探针作为纳米级电探针来扫描表面,从而同时测量样品的形貌和电导率。在给定的偏压下,通过电流放大器检测电流分布,并可视化局部电导率的异质性。此外,C-AFM还可以收集单点、多点或区域的电流-电压(IV)光谱。 一般来说,C-AFM是研究包括纳米颗粒、纳米线、碳纳米管、二维材料、薄膜涂层和块状材料在内的一系列材料电学性质的常用技术。它被应用于漏电流评估、半导体器件的失效分析以及二极管的开关特性研究。结合高压工具包、针尖纳米机械模式和/或具有定制样品支架的温度控制阶段,Park AFM上的C-AFM可以根据需要进行定制,并在各种测量条件下运行。

图1. C-AFM装置示意图,其中涂有导电材料的探针连接到电流放大器(黄色部分),该放大器检测通过样品支架施加的给定直流偏压下的电流信号。高度反馈同时调节Z扫描器以保持恒定的探针-样品力。
原则上,C-AFM(导电原子力显微镜)的操作与扫描隧道显微镜(STM)类似:在探针和样品之间施加偏压电压,并测量两者之间的电流或隧道电流。然而,这两种模式之间的主要差异在于所使用的探针类型和用于扫描的反馈信号。STM使用尖锐的金属线/探针,并通过基于金属线与导电样品之间隧道电流的反馈来维持恒定的探针-样品距离。而C-AFM使用带有金属或掺杂金刚石涂层或全金属探针的导电悬臂来扫描表面,同时通过反馈维持恒定的悬臂偏转,从而保持恒定的探针-样品力。由于C-AFM在接触模式下操作,这种探针-样品力处于短程排斥相互作用范围内。此外,STM仅限于良好导电的样品,以便在施加的偏压下检测到足够高的隧道电流,而C-AFM对样品材料没有限制,如导电材料、半导体以及导电/非导电材料的复合材料。
在C-AFM成像过程中,导电探针在接触模式下扫描样品表面,同时通过一个电流-电压前置放大器测量给定样品偏压下每个像素的电流流动,如图1所示。由于电流的大小可能根据样品的不同而从几皮安到毫安不等,因此应该选择匹配的电流放大器以适应不同样品的导电性。Park Systems提供了三种不同的电流放大器选项,以满足广泛应用的需求。第一种选项使用内置放大器,第二种选项包括一个外部可变增益、低噪声电流放大器(VECA),第三种选项是一个外部低噪声电流放大器(ULCA)。表1列出了每种放大器的可测量电流范围和规格。
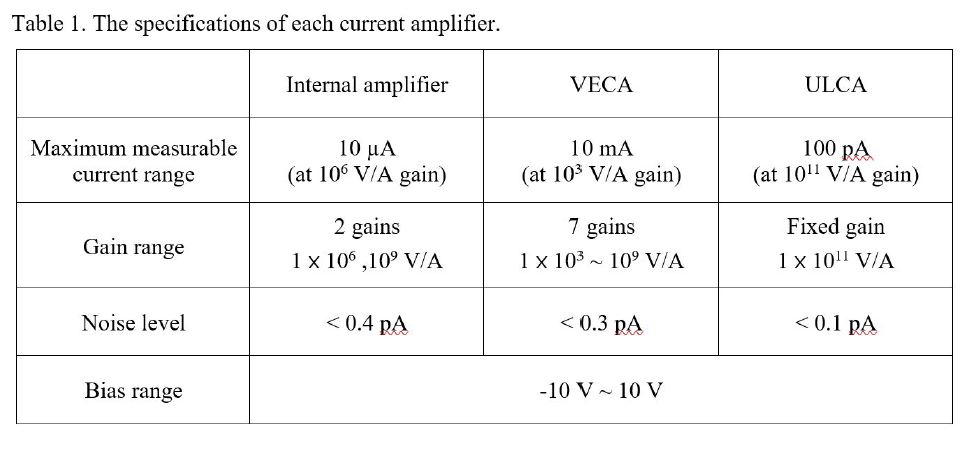
Park AFM的内部电流放大器可以测量高达10 μA的电流。根据样品电流信号范围的不同,内部放大器总共提供六种增益选择:两种前置增益用于低噪声,四种后置增益用于高速成像。VECA(可变增益、低噪声电流放大器)具有可变增益设置,可适应广泛的导电性,并检测高达10 mA的电流。对于皮安范围内的电流,必须将电噪声抑制到毫微微安级别。在这方面,ULCA(低噪声电流放大器)以其低噪声电路设计,可以测量0.1 pA到100 pA范围内的电流,这对于准确表征低导电性样品是必需的。此外,Park AFMs可以施加-10 V到10 V的直流偏压。但是,通过连接高压放大器,可以获得-150 V到150 V的偏压范围。
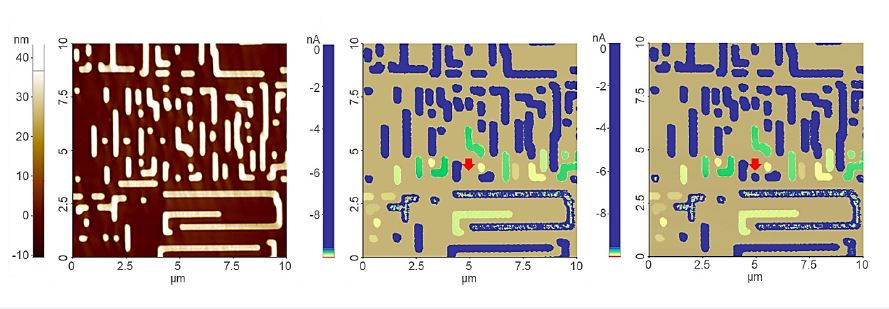
图2. 使用内部电流放大器对带有集成电路的半导体器件进行C-AFM测量以进行故障分析。(a) 样品高度,(b) 良好器件的电流图像,和(c) 不良器件的电流图像。图(b)和(c)中的红色箭头指出了失效器件组件的位置。
图2展示了使用内部电流放大器对半导体器件进行C-AFM测量以进行故障分析。器件的扫描尺寸为10 μm x 10 μm,样品偏压为-0.5V。高度图像(a)显示了从表面突出的器件组件的位置。电流图像(b)和(c)均显示了器件组件相对于基底的不同导电性水平。然而,不良器件的电流图像(c)清晰地显示了一个组件上存在的高泄漏电流,这在良好器件的电流图像(b)中是不存在的。这种泄漏电流可能导致由于短路引起的器件故障。
除了在给定的直流偏置下成像电流分布外,导电原子力显微镜(C-AFM)还支持电流-电压(IV)光谱测量。IV光谱测量电流作为与施加在样品上的探针偏压(V)之间的函数。为了研究样品表面的电学性质,可以在选择的样品区域上进行IV光谱测量,该区域在拍摄样品图像后确定。Park Systems的IV光谱模式允许在图像中自由选择多个点,或使用网格功能绘制IV曲线的体积区域,如图3所示,该图显示了SRAM器件上的情况。样品高度(a)和电流分布(b)通过C-AFM扫描进行测量,扫描尺寸为10 μm × 10 μm,样品偏压为-0.5 V。高度图像显示了表面的凸起,这些凸起在电流图像中表现出不同的导电性。随后,从-1 V到+1 V的IV光谱映射在(a)和(b)中标记为红色的位置上,使用32×64个点在2 μm×5 μm的区域内进行。从网格中的每个IV曲线中,可以分别重建在-1 V、0 V和1 V下的电流分布,如(c) -(e)所示。对IV数据的分析显示,凸起对施加的偏压有不同的响应:其中一些凸起仅在负偏压下导电,而其他凸起仅在正偏压下导电。在(c)和(e)中测量的单个IV曲线(f)说明了不同的IV行为。
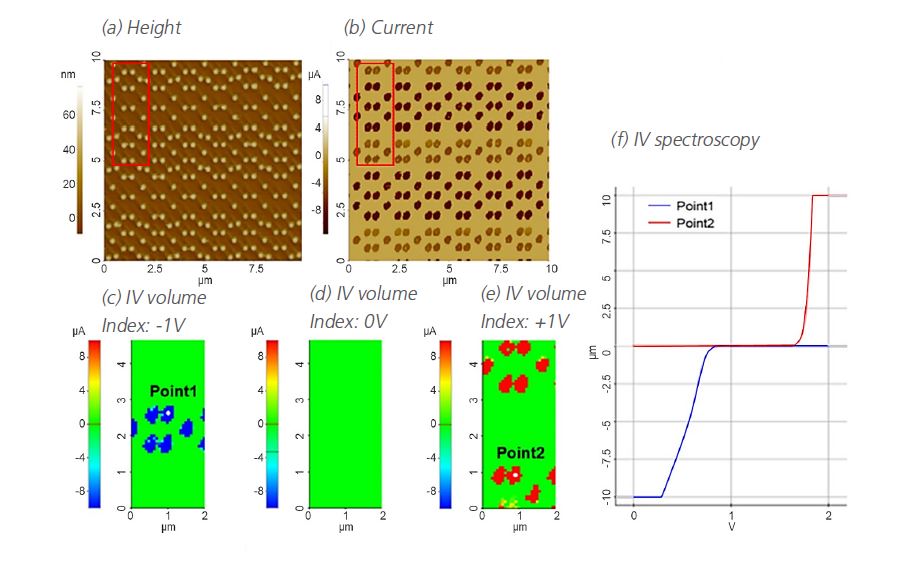
在图3中,我们看到了在SRAM器件上进行的C-AFM和IV光谱测量。样品高度(a)和电流(b)的IV映射区域显示为红色。在给定的偏压下,IV体积图像显示了不同的导电性,包括-1 V(c)、0 V(d)和+1 V(e)。在(c)和(e)中的点1和点2处的IV光谱曲线显示在(f)中。
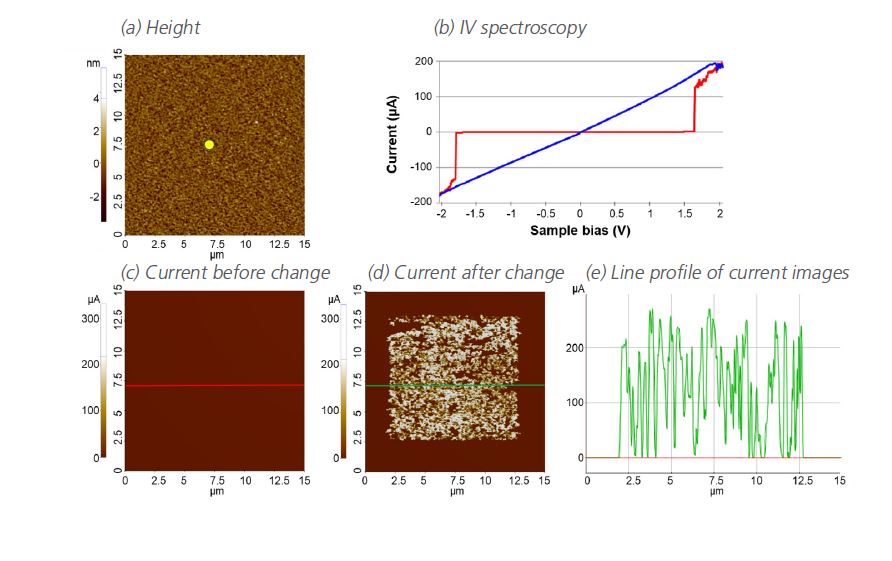
图4. 使用VECA进行电流检测的NiO样品中的C-AFM实验。(a) 样品高度,(b) 从-2 V到+2 V(红色)和反向(蓝色)的IV扫描,显示了阈值电压以上电流的急剧增加(IV位置在图(a)中以黄色标记)。在1 V样品偏压下,通过在10 x 10 μm区域内施加2.5 V样品偏压来改变导电性之前(c)和之后(d)的电流图像。从图(c)和(d)中红色和绿色线位置提取的线轮廓图(e),以可视化电流的突然增加。
图4总结了使用VECA在NiO表面成像电流分布的C-AFM实验。在扫描之前,进行了IV光谱测量(b),以检查样品电流范围与施加样品偏压的关系。在正向扫描中,样品偏压逐渐从-2 V增加到+2 V(红色),在反向扫描中,偏压从+2V减小到-2V(蓝色)。在正向扫描中,当样品偏压在-1.8 V到+1.7 V之间时,样品没有电流信号。然而,一旦样品偏压超过±1.7 V的阈值电压,检测到的电流突然增加,并且在反向扫描中样品保持高导电性。因此,IV光谱数据表明,一旦超过阈值电压,样品的导电性就会永久改变。
图4中的(c)和(d)电流图像证实了超过阈值电压后导电性的变化。在初始扫描(c)中,扫描区域为15 μm x 15 μm,使用+1 V的样品偏压没有检测到电流信号。为了改变电导率,随后的10 μm x 10 μm测量中施加了+2.5 V的样品偏压,这超过了阈值电压。图像(d)显示了第二次扫描期间表面导电性改变后,在+1 V样品偏压下的第三次C-AFM测量的电流信号。在电流图像和线轮廓图(e)中,可以清楚地看到在同一位置施加2.5 V前后测量的电流差异。由于样品在改变导电性后的电流范围在几百微安的量级,因此选择了104 V/A的电流放大器增益来覆盖VECA上的样品电流范围,从而实现可测电流高达1 mA。

图5. 使用ULCA在-4 V样品偏压下对Ni上的并五苯进行C-AFM测量。(a) 样品高度,(b) 电流图像,以及(c) 从(b)中的红线提取的线轮廓图。
图5展示了Park Systems的C-AFM在并五苯涂层的Ni样品上测量仅几个pA量级的小电流的能力。样品以2 μm x 2 μm的扫描尺寸进行扫描,样品偏压为-4 V,并使用ULCA测量电流信号,其电流增益为1011V/A。样品上测得的最大电流值在主体晶粒顶部低至-3 pA,而晶界处的电流信号为零。此外,(c)中的线轮廓图进一步显示了ULCA可以实现的低噪声水平。
